針對新一代高性能氮化物寬禁帶半導體器件與異構集成電路發展的需要,基于二維材料插層的氮化物半導體范德華外延技術因其柔性和可轉移性,突破了傳統外延的物理限制,是實現多種半導體材料的異質異構集成與功能創新的重要途徑。然而,石墨烯等二維材料表面惰性導致的氮化物成核難題是制約范德華外延氮化物半導體材料與器件發展的關鍵瓶頸。近日,一項關于范德華外延高質量超薄氮化物半導體材料的研究成果發表于《Advanced Materials》,該研究由武漢大學何軍教授團隊與西安電子科技大學郝躍院士團隊張進成教授、寧靜教授合作完成,武漢大學文耀副研究員與西安電子科技大學寧靜教授與為論文共同第一作者,何軍教授、張進成教授為論文共同通訊作者。

氮化物范德華外延是指通過二維材料插層異質外延III氮化物半導體薄膜,借助范德華界面能夠實現氮化鎵等外延材料的應變弛豫、位錯密度降低和無損異質集成。然而,在二維材料上外延III族氮化物時,二維材料的有限潤濕性和弱界面相互作用使得在晶圓尺度上實現III族氮化物半導體的有序晶體取向和高質量薄膜制備非常困難。本研究創新性地提出了一種范德華極化工程異質集成方法(Polarization-engineered vdW integration strategy),利用III族氮化物中Al面的極性與二維材料之間的偶極矩關系,在外延襯底中設計穩健的電子極化增強界面的靜電勢、電荷相互作用和結合能,二維材料的缺陷和通孔將促進準范德華外延生長,形成可以與外延產物結合的不飽和懸掛鍵,實現了III族氮化物半導體和襯底之間的電荷轉移,從而在二維材料上制備出4英寸高質量超薄GaN異質外延材料,并且當外延層厚度減小到400 nm時,仍可維持低位錯密度(3.49×108 cm-2)。基于該技術制備的GaN異質結構二維電子氣室溫遷移率達2080.7 cm2 V-1 s-1,高電子遷移率晶體管(HEMT)展示出790 mA/mm的高飽和電流密度和1.11×10?? mA/mm的低截止電流。該成果為高質量氮化物半導體的范德華外延和異質集成提供了新機理,解決了氮化物寬禁帶半導體范德華外延的關鍵難題,實現了高質量超薄氮化物異質結構材料,為高性能寬禁帶半導體器件的跨材料、跨功能的大面積異構集成掃清了關鍵障礙。
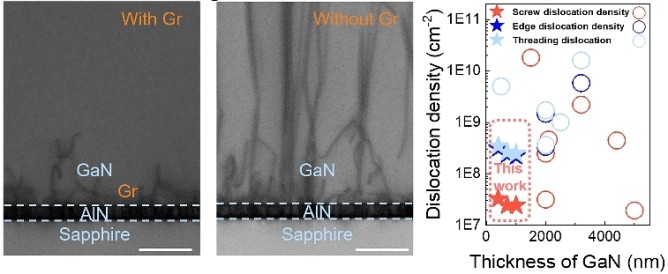
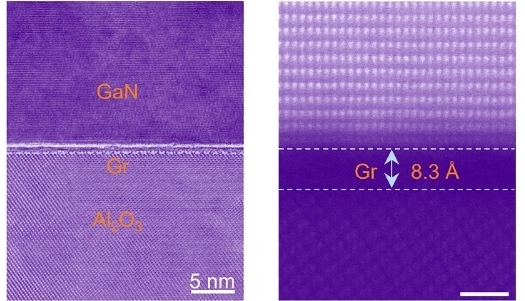
圖1 基于石墨烯插層的范德華外延氮化鎵外延材料

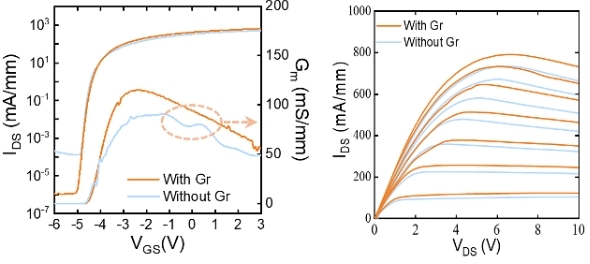
圖2 范德華外延與傳統異質外延氮化物外延材料與HEMT器件比較
文章信息:Yao Wen, Jing Ning, Haidi Wu, Haoran Zhang, Ruiqing Cheng, Lei Yin, Hao Wang, Xiaolin Zhang, Yong Liu, Dong Wang, Yue Hao, Jincheng Zhang*, Jun He*,Van der Waals integration of 4-inch single-crystalline III-nitride semiconductors, Adv. Mater. 2025, 2501916, https://doi.org/10.1002/adma.202501916
